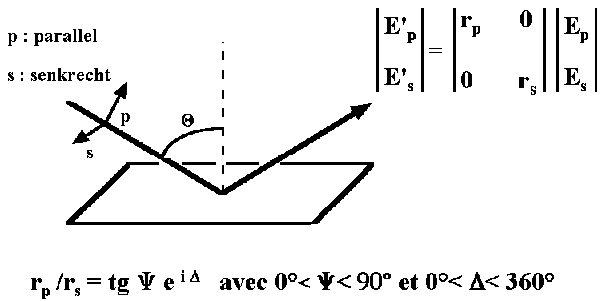
Ce chapitre introduit essentiellement l'ellipsométrie des couches minces en trois points :
La lumière est une onde électromagnétique et dans le domaine visible l'essentiel des interactions avec la matière s'explique en raisonnant sur le seul champ électrique sur la base des modèles dipolaires simplifiés.
L'ellipsométrie des couches minces mesure en fait le rapport des réflectances complexes.
La mesure de la polarisation lumineuse pose un problème de repère
dans l'espace ; la direction de la lumière incidente et la normale
à la surface définissent le plan d'incidence ; le repère
naturel de la mesure ellipsométrique par réflexion est donné
par les directions parallèle (notée p comme parallel ) et
perpendiculaire (notée s comme senkrecht) au plan d'incidence orthogonalement
à la direction de propagation de la lumière.
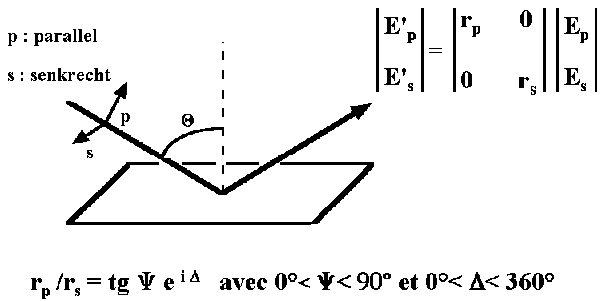
Quand la surface stratifiée est constituée de matériaux homogènes et isotropes latéralement (i.e. le tenseur diélectrique peut être déformé parallèlement à la normale de la surface), la lumière polarisée parallèlement ou perpendiculairement au plan d'incidence conserve sa polarisation linéaire après réflexion mais subit une atténuation et un déphasage caractérisés par les quantités complexes rp et rs appelées réflectances :
rp=Atténuation_p*exp(i*Phase_p)
rs=Atténuation_s*exp(i*Phase_s)
La variation d'état de polarisation lors d'une réflexion est caractérisée par les paramètres angulaires Psi et Delta définis par le rapport des réflectances :
rp/rs=Tan(Psi)*Exp(i*Delta)
La tangente de l'angle Psi est donc le rapport des atténuations :
Tan(Psi) = Atténuation_p/Atténuation_s
L'angle Delta est l'écart de déphasage entre la composante de polarisation p et la composante de polarisation s :
Delta = Phase_p - Phase_s
L'angle d'incidence pour lequel la polarisation p de la lumière n'est pas réfléchie sur une surface diélectrique s'appelle angle de Brewster ; cet angle remarquable est égal à l'arctangente de l'indice du substrat et, l'onde réfléchie est orthogonale à l'onde réfractée.

Pour revenir au sens premier de l'ellipsométrie, il existe des relations de trigonométrie sphérique qui lient les quantités Psi et Delta aux ellipses de lumière refléchie correspondant à une lumière incidente polarisée linéairement à 45° du plan d'incidence :

Le calcul multicouche courant en ellipsométrie s'appuie sur l'hypothèse d'ondes planes monochromatiques réfléchies spéculairement par des surfaces planes stratifiées ; les quantités ellipsométriques Psi et Delta sont alors calculés à partir des termes de propagation et des relations de Fresnel aux interfaces en tenant compte des interférences multiples [Born & Wolf].
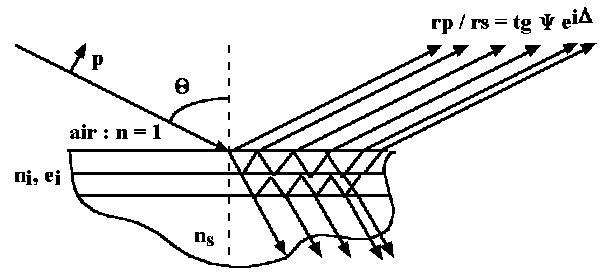
![]()
Y = F1(q, l, ns, ni, ei) ; D = F2(q, l, ns, ni, ei)
Psi et Delta sont fonctions de l'angle d'incidence, la longueur d'onde,
l'indice du substrat ns et de l'indice ni et épaisseur
ei des i couches. Pour les couches transparentes, Psi et Delta
sont fonctions périodiques de leur épaisseur ; la période
est fonction de la longueur d'onde lumineuse, de l'indice de réfraction
de la couche et de l'angle d'incidence.
Tous les montages ont intérêt à utiliser de la lumière complètement polarisée et, donc, utilisent un polariseur d'entrée (polariseur) et un polariseur de sortie (analyseur).
Les ellipsomètres à méthode de zéro (Null Ellipsometer) utilisent un polariseur suivi d'une lame quart d'onde dont la ligne neutre est à quarante cinq degrés du plan d'incidence ; le polariseur et l'analyseur sont tournés alternativement jusqu'à extinction de la lumière émergente. L'orientation du polariseur donne Delta et celle de l'analyseur Psi.
Les modèles AutoEl IV de la société américaine Rudolph du début des années 1980 trouvaient automatiquement le minimum d'intensité lumineuse en une trentaine de secondes en tournant alternativement le polariseur et l'analyseur.
Cette technique classique est précise mais lente ; elle présente aussi l'avantage de ne pas nécessiter de photodétection linéaire puisqu'elle est asservie à une extinction de la lumière.
Les ellipsomètres à modulateurs utilisent les harmoniques du signal photométrique pour mesurer les paramètres ellipsométriques ; Psi et Delta sont calculés à l'aide des amplitudes et des phases extraites du signal photométrique. Parmi les techniques il y a :
L'avantage de cette technique de mesure est l'utilisation des seules parties modulées du signal, ce qui permet de s'affranchir du signal continu qui peut être perturbé par un fond lumineux continu.
La modulation de polarisation par biréfringence tournante
présente aussi l'avantage sur tous les autres types de modulation
périodique de couvrir les 3 dimensions de l'espace de Poincaré
(extension de la représentation de la sphère
de Poincaré à l'espace normé des paramètres
de Stokes S1, S2 et S3 pour la lumière complètement polarisée)
: l'harmonique H2 correspond à une lumière polarisée
circulaire alternativement gauche et droite et l'harmonique H4 correspond
à une lumière linéairement polarisée tournante
identique à celle produite par un polariseur tournant à la
pulsation 2w.
L'ellipsométrie sert aussi à mesurer les indices de réfraction mais cette mesure ne peut se faire que pour certaines conditions d'épaisseur et la précision atteind difficilement 10-5 : d'une certaine façon l'ellipsométrie n'est pas une bonne méthode pour mesurer les indices mais c'est souvent la seule !
L'ellipsométrie peut aussi servir à mesurer les rugosités d'interface, les concentrations, les porosités, les contraintes, les tenseurs diélectriques ... beaucoup de ces calculs sont encore du domaine de la recherche et ne sont pas disponibles sur les machines du commerce.
Cette page WEB se contente de rappeler le principe de calcul classique d'épaisseur et d'indice. Les calculs précis sont discutés séparément sur la base d'analyse de codes source.
ei = G1(Ymes, Dmes, l,q,niautres,eiautres,ns).
ni = G2(Ymes, Dmes, l,q,niautres,eiautres,ns).
Cette extraction s'inspire souvent de la méthode décrite par [Reinberg] qui part d'un indice et itère numériquement à la façon d'un calcul de Newton.
La connaissance de deux quantités réelles Y et D fonctions des variables du système multicouche (l,q,ni,ei,ns) permet, à priori, de calculer n'importe quel couple de quantités réelles dudit modèle multicouche : il y a bien deux équations qui lient Psi et Delta au modèle multicouche, alors deux inconnues peuvent être déterminées.
En fait, ce calcul suppose la connaissance parfaite du système multicouche et il est souvent préférable de comparer les valeurs de Psi et Delta mesurées à celles calculées ; cette comparaison de valeurs mesurées et calculées permet de vérifier le modèle multicouche choisi ou paradoxalement la qualité des mesures ellipsométriques (appareil mal qualibré, source lumineuse défaillante, bruit excessif dans la mesure ...).
Les équations ellipsométriques sont proches des relations réflectométriques ; c'est à dire que les indices et épaisseurs sont liés par la notion de chemin optique (c'est le produit ni*ei) en conséquence une erreur sur l'indice produit sur le calcul de l'épaisseur une erreur qui s'ajoute au bruit de mesure, aux erreurs de modèle et à la divergence des calculs d'indice au voisinage des passages de périodes. La conséquence pratique de ce problème de chemins optiques est de toujours commencer par effectuer les mesures d'épaisseurs en fixant les indices ; quand les indices sont fixés, si l'erreur de modèle multicouche ne dépasse pas quelques pourcents, la mesure d'épaisseur reste très sensible et ne présente qu'une erreur systématique de décalage.
En résumé les mesures (modèles) ellipsométriques disponibles sur beaucoup de machines commerciales sont :
Aucun équipement ne permet actuellement d'effectuer des mesures d'épaisseurs et d'indice de multicouches sans qu'un opérateur lui ait expressément indiqué les empilements et les matériaux en présence ainsi que les quantités qu'il choisit de mesurer ; les ellipsomètres spectroscopiques qui disposent pourtant souvent de suffisamment de données (mesures, bases de données matériaux et modèles de dispersion et de mélange) ne proposent toujours pas de logiciels à la hauteur de ce qui se fait de mieux en matière de vérification de cohérence d'interprétation de mesure.
Les chaînes logicielles comprennent typiquement trois composantes :
En dehors de la bibliographie succincte jointe il existe plusieurs sites d'ellipsométrie intéressants dont celui de l'université Cornell (Ellipsometry on the WEB) qui semble malheureusement ne plus être mis à jour ; le site de la société SOPRA offre de belles explications sur l'ellipsométrie, un grand nombre de fichiers d'indices (n -i*k) de matériaux et des logiciels de simulation et d'interprétation de spectres Tan(Psi) et Cos(Delta).
La correction de cette page est assurée par Aimé Vareille
[Shurcliff W. A.] Polarized Light, Harvard
University Press, Cambridge, Mass. 1962, 1966.
[Azzam & Bashara] Ellipsometry and Polarized
Light, R.M.A. Azzam et N.M. Bashara, North Holland Publishing Company 1977.
[Born & Wolf] Principles of Optics, Max BORN
and Emil WOLF, Pergamon Press 1975.
[Reinberg] Ellipsometer Data Analysis with a
Small Programmable Desk Calculator, Alan R. Reinberg, May 1972, Vol. 11,
n°5, APPLIED OPTICS.
Poincaré (H.), "Théorie Mathématique
de la Lumière", Paris, Georges Carre, Vol.2, (1892) Chap.12.