Page
suivante Page
précédente Table
des
matières
Foire Aux Questions
1)
Quelles
sont les relations de trigonométrie sphérique qui lient les
couples (alpha, lambda) et (psi, delta) ?
2) Comment
établit-on les équations instrumentales des ellipsomètres à
analyseur tournant et quart d'onde amovible ?
3)
How
to obtain the detected intensity of a Phase Modulated Ellipsometer
in the form : I(l,t)= I (I0+ Is sin d (t) + Ic cosd (t)) ?
4) Que donne
l'ellipsométrie sur des couches rugueuses, trouées ou en ilôts ?
5) Quels sont les
programmes proposés dans ces pages d'ellipsométrie, peut-on les
télécharger seuls ?
6) What about oil film
measurement on tinplate. chrome oxide (tin free steel),
steel, aluminum, and other metals ?
7) Pourriez vous nous
indiquer une présentation simplifiée de l'ellipsométrie ?
1)
Je voudrais savoir comment on retrouve les équations de
trigonométrie sphérique qui lient les couples (alpha,lambda) au
couple (psi,delta).
Ces relations sont relatives aux formes d'ellipses de lumière qui
sont caractérisées par deux quantités angulaires ; celles ci sont
soit le couple (alpha, lambda) où alpha est l'orientation angulaire
de l'ellipse et lambda l'aplatissement de l'ellipse, soit le couple
(psi, delta) où psi est le rapport angulaire des composantes
transversales et delta le déphasage entre les deux composantes.
En choisissant d'appeler psi et delta les composantes du deuxième
couple, on introduit une ambiguïté sur les quantités Psi et Delta de
l'ellipsométrie des couches minces qui concernent le rapport des
réflectance d'une surface multicouche en un point (rp/rs = tan
(Psi)eiDelta) ; nous allons lever cette confusion en
précisant dans quel cas les composantes d'une lumière réfléchie
peuvent prendre effectivement le même rapport d'amplitude Psi et
déphasage Delta que rp/rs.
Une ellipse de lumière d'aplatissement lambda et d'orientation
alpha du grand axe s'écrit :

Où la matrice carrée exprime la rotation d'un angle alpha de
l'ellipse d'aplatissement lambda d'axes alignés au repère.
L'autre façon de décrire la même ellipse de lumière est de la
considérer constituée de composantes de phase béta et gamma et de
rapport angulaire d'amplitude psi :

Dans cette équation paramétrique seule 2 variables angulaires sont
caractéristiques de la forme de l'ellipse :
- Le rapport angulaire des amplitudes des composantes : psi
- La différence de phase des composantes : delta = gamma - béta
En identifiant chaque composantes en quadrature on obtient quatre
relations trigonométriques liant les quantités angulaires
caractéristiques de la forme de l'ellipse :

Il s'agit maintenant d'extraire des 4 relations, 3 relations de
trigonométrie sphérique remplaçant béta et gamma par leur différence
delta.
Il s'agit là d'un pur jeu de combinaisons mathématiques permettant
d'obtenir des expressions géométriquement interprétables :
En effectuant de part et d'autre les combinaisons de relations :
1x1 + 2x2 - 3x3 - 4x4 on obtient :

En effectuant de part et d'autre les combinaisons de relations :
1x3 - 2x4 on obtient :

En effectuant de part et d'autre les combinaisons de relations :
1x4 + 2x3 on obtient :

Dans la représentation de Poincaré, la forme de l'ellipse est
représentée par un point de coordonnée sphérique (2*alpha,
2*lambda) ; dans ce même espace de Poincaré les angles 2*psi et
delta sont aussi des coordonnées sphériques du même point
caractéristique de la même forme d'ellipse :

Pour revenir sur la signification particulière des quantités
angulaires Psi et Delta en ellipsométrie des couches minces :
considérons une surface plane isotrope ; les propriétés
réflectives de cette surface sont caractérisées par une matrice
diagonale des quantités rp et rs respectivement réflectances
complexes pour les axes p et s (p parallèle et s perpendiculaire
au plan d'incidence).
Ainsi, une lumière incidente polarisée linéairement à 45° du plan
d'incidence (psi=45° et delta=0°) est transformée en une lumière
de rapport angulaire d'amplitude égal à Psi (psi = Psi) et de
déphasage égal à Delta (delta = Delta) où Psi et Delta sont les
quantités angulaires caractéristiques de la surface réfléchissante
(rp/rs = tan (Psi)eiDelta), tandis que psi et delta
(premières lettres p et d minuscules) sont caractéristiques de la
forme de l'ellipse de lumière respectivement avant (psi=45°,
delta=0°) et après réflexion (psi=Psi, delta=Delta).

2) J'ai toujours un
problème avec la décomposition de l'intensité lumineuse en
série de Fourier de la valeur angulaire A de l'analyseur :
-Je ne comprends pas pourquoi on a du cos(2A) et sin(2A) au lieu
de cos(A) et sin(A) dans I=Io+I1cos(2A)+I2sin(2A)
-Je ne parviens pas à retrouver mathématiquement les valeurs de
a et de b dans:
I=Io(1+acos(2A)+bsin(2A))
avec a=I1/Io=((tan(psi))^2-(tan(p))^2)/((tan(psi)^2+(tan(p))^2)
et b=I2/Io=(2tan(psi)tan(p)cos(delta))/((tan(psi))^2+(tan(p))^2)
D'ou viennent ces tangentes ?
Cette question se réfère à ce type d'ellipsomètre :
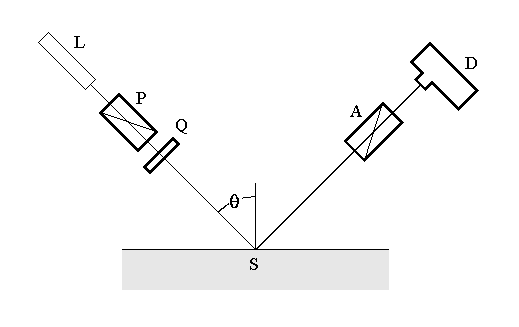
avec :
- L : laser
- P : polariseur à 45° de p (intersection du plan d'incidence
avec le plan d'onde)
- Q : compensatrice ou plus précisément lame quart d'onde
amovible de lignes neutres parallèle à p et s
- A : analyseur tournant (c'est à dire polariseur de sortie)
- D : photodétecteur permettant une détection linéaire de
l'intensité lumineuse émergente
- S : surface à analyser qui est caractérisée par la matrice E
(Echantillon) dans les équations exposées plus bas.
Ce type de montage pourrait être utilisé en méthode d'annulation
(nulling ellipsometer) la Société Rudolph a longtemps commercialisé
un modèle automatique (Auto EL IV) ; notre site d'ellipsométrie
décrit avant tout un procédé utilisant les mêmes composants mais
faisant tourner la compensatrice associé à un mode de détection
photométrique permettant d'extraire Psi et Delta à partir des
harmoniques 2 et 4 de la fréquence de rotation. dans le cas présent,
ce montage est utilisé en mode photométrique à analyseur tournant
avec une lame quart d'onde amovible : les Sociétés Gaertner et
Philips Analytical (anciennement Plasmos) commercialisent des
modèles basés sur ce principe.
La mesure se fait en deux temps, sur la base d'une décompostion en
série de Fourier des harmoniques de l'angle de l'analyseur :
- Extraction des harmoniques H0 et H2_cos et H2_sin sans
compensatrice qui permet le calcul de tan(Psi) et cos(Delta).
- Extraction des harmoniques H0 et H2_cos et H2_sin avec
compensatrice qui donne tan(Psi) et sin(Delta) permettant ainsi,
avec la mesure précédente, d'obtenir une détermination complète
du déphasage Delta.
On peut effectuer le calcul ellipsométrique complet en utilisant les
matrices de Jones ; ce calcul est assez fastidieux et noye l'analyse
de Fourier dans la mesure où il se termine par le passage des
expressions d'amplitude en intensité (I = EpEp* + EsEs*) (cf. La
page de D. J. De Smet (http://www.onramp.tuscaloosa.al.us/~ddesmet/bk/closlook.html)
sur les ellipsomètres à annulation ):
Compte tenu du nécessaire calcul de l'intensité lumineuse et de
la commodité des représentations géométriques de Poincaré il est
particulièrement intéressant de faire ces calculs ellipsométriques
à l'aide des paramètres de Stokes et des matrices de Mueller :
c'est en gros ce que démontre la question posée.
Le fait que ce soient les harmoniques doubles H2 de l'angle A de
l'analyseur qui apparaissent dans l'expression de l'intensité
vient de ce que les matrices de Jones introduisent de l'harmonique
H1 de l'angle A et le passage final au calcul de l'intensité donne
forcément et uniquement des harmoniques multiples de 2 dans le cas
des optiques tournantes.
En pratique, il y a toujours un peu d'harmonique simple H1
résiduel du fait des inhomogénéités et salissures de l'optique
tournante ou du mauvais centrage du faisceau lumineux qui touche
les bords ou renvoie des reflexions parasites dans le
photodétecteur.
Pour ce qui est de l'établissement des formules, nous laissons le
soin au lecteur d'utiliser les paramètres de Stokes et les
matrices Mueller comme nous le décrivons en http://aime.vareille.pagesperso-orange.fr/pages/ellipsometrie/null.html
et en http://aime.vareille.pagesperso-orange.fr/pages/ellipsometrie/In-situ.htm
; il y a en fait 2 équations instrumentales :
1) L'intensité sans compensatrice s'écrit :

2) L'intensité avec compensatrice s'écrit :

Où T = 0° et les matrices E (Echantillon) , R (Rotation :
orientation T de la compensatrice) et B (Biréfrengence de la
compensatrice) sont décrites en http://aime.vareille.pagesperso-orange.fr/pages/ellipsometrie/null.html.

3) How to obtain the detected intensity of a Phase
Modulated Ellipsometer (PME) in the form : I(l,t)= I (I0+ Is sin d
(t) + Ic cosd (t)) ?
This kind of PME ellipsometer is described at http://www.isainc.com/frthinfilm/Uvisel_formalism.htm#OPTICAL
FORMALISM :
Let us, consider the Uvisel Spectrometric Ellipsometer of Jobin Yvon
SA :
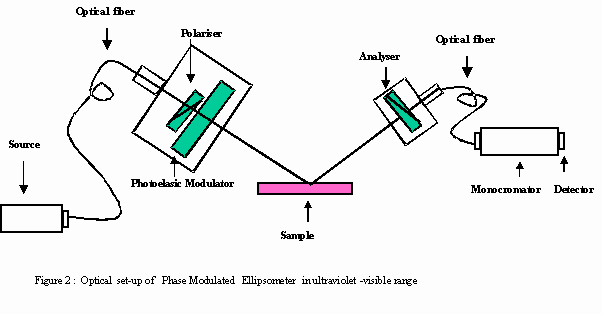
Keeping the same notations, the respective orientations of the
polarizer, modulator and analyzer, referred to the plane of
incidence, are respectively denoted P, M and A.
In order to avoid confusing formulae, it is preferable to choose b
(instead of big bold A) as modulation amplitude of
the birefringence of the photoelastic modulator ; the sinusoidal
variation of the birefringence  is proportional to the stress through the
Brewster photoelastic coefficient C of the fused silica of the
Modulator :
is proportional to the stress through the
Brewster photoelastic coefficient C of the fused silica of the
Modulator :

Where  is the wavelength of the used light, e is the
thickness of the Modulator crossed by the light and
is the wavelength of the used light, e is the
thickness of the Modulator crossed by the light and  is the stress amplitude
produced by the piezo transducer of the Modulator where the light
is passing.
is the stress amplitude
produced by the piezo transducer of the Modulator where the light
is passing.
Using de Stokes and Mueller matrices, we obtain the following
intensity expression for the Uvisel ellipsometer :

Where the Photo Elastic Modulator (PEM) Q and the sample E
are characterized by the Matrices :


Making all the matrices multiplications, the relations given for
the Uvisel ellipsometer should be retrieved :

Where :



And then the Bessel development can be applied :



4) Que donne
l'ellipsométrie sur des couches rugueuses, trouées ou en ilôts ?
Compte tenu de la structure atomique de la matière il n'existe pas
de surfaces ou de couches parfaitement lisses : l'ellipsométrie des
couches minces ne caractérise fondamentalement que des structures
rugueuses.
Pour illustrer ces propos observons la couche mince la plus
caractérisée au monde, celle de silice thermique sur silicium :
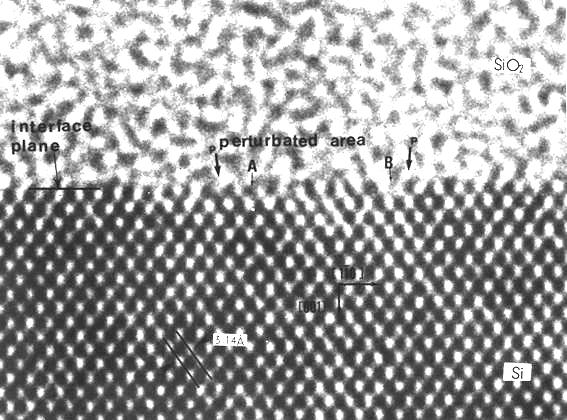
Cette image obtenue en microscopie haute résolution en
transmission par une équipe mixte du CENG et du CNET (http://perso.wanadoo.fr/anterroches/micro/Prin_TEM_html.htm)
montre l'interface de la silice avec le silicium (100).
Le silicium monocristallin (cubique diamant de distance
interatomique de 0.314 nm) découpé suivant un angle de
l'ordre du degré avec le plan cristallographique (100) (cf. les
standards de l'industrie microélectronique : ASTM F1241) offre une
rugosité naturelle de passage des sites A et B augmentée des
décrochements des plans cristallins fonction de l'angle de coupe.
L'image montre un speckle homogène pour la silice thermique
caractéristique de son état vitreux parfaitement désordonné sur du
silicium monocristallin (100) parfaitement ordonné ; on peut
ajouter que la silice thermique est en forte compression
(typiquement plus de 150 MPa) et le silicium en extension
(typiquement de l'ordre du Mpa) à cause de l'augmentation de
volume due à l'adjonction d'oxygène au silicium pour former la
silice et surtout à cause des différences de coefficient de
dilatation lors du refroidissement (la silice n'est pâteuse que
bien au dessus de 500°C et le silicium plastique qu'à partir de
400°C).
De nombreuses publications d'ellipsométrie traitent de la rugosité
des interfaces ; parmi les caractérisations expérimentales
poussées on peut citer :
- Avec un ellipsomètre monochromatique utilisant une raie verte
du mercure (546.1 nm), les mesures ellipsométriques ont révélé
une rugosité de 0.6 nm pour l'interface silice sur silicium
monocristallin découpé suivant un plan proche de (111) ; cette
rugosité a été chiffrée en faisant l'hypothèse d'une couche
interfaciale d'indice (2.8) intermédiaire à la silice (1.4626)
et au silicium (4.086 -i 0.031) : "Optical Evidence for a
Silicon-Silicon Oxide Interlayer", J. Electrochem. Soc. :
Solid-State Science and Technology, Vol. 126, n°1, pp.131-134
(1979), E. Taft and L. Cordes.
- Les mesures d'ellipsométrie spectroscopique sur des couches
minces de silice sur silicium ont conforté expérimentalement
l'emploi de couches minces interfaciales d'indice intermédiaire
suivant des modèles de mélanges de milieux effectifs pour
caractériser quantitativement les rugosités : "Investigation
of effective-medium models of microscopic surface roughness by
spectroscopic ellipsometry", D. E. Aspnes, J. B. Theeten,
F. Hottier (Physical Review B 1979).
- Les rugosités ellipsométriques ont été comparées aux valeurs
mesurées par profilométrie mécanique dans le cas de l'oxydation
de couches minces de silicium polycristallin ; la limite
raisonnable d'interprétation de la rugosité par des couches
interfaciales ou superficielles d'indice intermédiaire suivant
une loi de mélange de mileux effectifs a été expérimentalement
située aux alentours de 100 nm (pour la silice sur silicium
polycristallin) : "Optical characterization of
polycristalline silicon before and after thermal oxidation",
Thin Solid Films, 125, (1985) pp. 235-241, P. Montaudon, M. H.
Debroux, F. Ferrieu and A. Vareille.
Un cas bien connu de couche rugueuse d'abord en ilôts puis trouée
est celle de l'oxyde natif du silicium : le silicium fraîchement
désoxydé par une solution d'acide fluorhydrique, se couvre en
quelques heures à l'air libre d'une couche qualifiée d'oxyde natif
(cf.
http://aime.vareille.pagesperso-orange.fr/pages/ellipsometrie/mesures.html)
:

Cette première partie de réponse ne concerne que les rugosités
petites devant la longueur d'onde lumineuse : en résumé, il semble
que les relations de Fresnel soient suffisamment robustes pour
rendre compte quantitativement de rugosités inférieures au quart
de la longueur d'onde lumineuse en faisant l'hypothèse de couches
minces interfaciales d'indice intermédiaire aux matériaux en
présence.
Maintenant considérons à l'autre extrême les trous dans les
couches minces ou les ilôts de couches minces d'étendues de
plusieurs fois supérieures à la longueur d'onde lumineuse (e. g.
de plusieurs microns à plusieurs mm pour les faisceaux de mesure
ellipsométrique étendus) : que donnent les mesures
ellipsométriques sur de telles surfaces hétérogènes ?
Le photodétecteur de l'ellipsomètre reçoit l'énergie lumineuse
provenant de zones qui ne produisent pas les mêmes interférences.
Ces énergies lumineuses n'interfèrent pas entre elles (c'est
particulièrement vrai quand on forme l'image de l'échantillon sur
le photodétecteur) ; fort de cette hypothèse, l'intensité
lumineuse détectée est la somme des intensités lumineuses et les
vecteurs de Stokes des formes de lumières réfléchies
s'additionnent : il s'agit d'une addition incohérente des formes
de lumière ; c'est un cas connu de dépolarisation spatiale
utilisée en photoélasticimétrie holographique. Pratiquement, un
ellipsomètre à annulation ne parviendra pas à éteindre la lumière
émergente, il trouvera un minimum d'intensité lumineuse qui est
calculable et qui peut masquer l'effet des zones qui réfléchissent
peu de lumière ; pour calculer ces minima il faut connaître les
différents multicouches en présence et estimer leurs surfaces
relatives, calculer les vecteurs de Stokes pour chaque structure
pour les additionner ... c'est tout à fait faisable et vérifiable
mais peu de constructeurs d'ellipsomètres proposent les logiciels
pour simuler ce cas et traiter les mesures.
Dans les cas intermédiaires, quand la rugosité est comparable
en dimension à la longueur d'onde lumineuse la lumière est
diffractée; les réseaux de diffraction en sont des cas
particuliers qui ont d'ailleurs déjà fait l'objet d'assez
nombreuses études ellipsométriques. Pour étudier de telles
surfaces, il est intéressant de disposer d'ellipsomètres à
photodétection d'angle solide bien calibré pouvant scruter
l'ensemble de l'indicatrice de diffusion, la direction spéculaire
n'étant plus la seule à renvoyer des informations exploitables.
En conclusion, les relations de Fresnel utilisées en
ellipsométrie rendent bien compte de comportements statistiques
des interactions lumière-matière de faisceaux lumineux
intrinsèquement statistiques de photons avec des surfaces
rugueuses dont les topologies sont en grande partie de nature
statistique ; autrement dit, avec l'amélioration de la sensibilité
des mesures ellipsométriques autour du picomètre il reste beaucoup
à faire avec la puissance de calcul temps réel des ordinateurs
actuels pour transformer cette sensibilité en précision à la fois
sur le plan des modèles statistiques et sur le plan des suivis
temps-réel des surfaces (transformations chimiques, physiques,
vibrations et acoustiques (phonons ...)).

5) Quels sont
les programmes proposés dans ces pages d'ellipsométrie, peut-on
les télécharger seuls ?
Tous les programmes présentés sont des logiciels libres sous license
GPL (General Public License) : http://www.gnu.org/copyleft/gpl.html
Il y a actuellement 3 programmes FORTRAN 77 et un programme JAVA :
- rngl.f
:
- C Calcul des harmoniques d'un ellipsometre a birefringent
tournant :
- C Psi et Delta pour une couche mince transparente sur
substrat
- C Indice de substrat a partir de Psi et Delta
- C Epaisseur d'une couche mince a indice fixe sur substrat
- C Epaisseur et indice d'une couche mince sur substrat
- C Coefficients de reflexion Rp et Rs
- C Harmoniques H0, H2 et H4 pour une couche mince donnee sur
substrat
- C Psi et Delta en fonction des harmoniques H2 et H4
- sigmd.f
:
- C CALCUL DE REPARTITION DES CONTRAINTES ET DEFORMATIONS
- C DU SYSTEME : COUCHE MINCE DE SILICE SUR SUBSTRAT DE
SILICIUM
- indce.f
:
- C CALCUL D'INDICES DE REFRACTION :
- C Si cristallin : tables interpolées
- C SiO2 : série de Sellmeier et coefficients de Brewster
(autrement dit : biréfringence accidentelle ou
photoélasticité)
- C Si amorphe : tables interpolées
- C SiOx : tables interpolées et mélanges effectifs
- C Al : tables interpolées
- C Si3N4 (nitrure de silicium) : tables interpolées
- Telem.java
:
Les trois programmes FORTRAN 77 sont compilables avec le
compilateur GNU g77, il suffit de taper dans une fenêtre shell de
linux ou cygwinde windows :
g77 -o program.exe program.f
Ces programmes FORTRAN sont dans un fichier ellipf77.zip
qui contient les sources et les exécutables linux (suffixe lnx) et
windows (suffixe w) ; attention, en l'absence de l'environnement cygwin le fichier
cygwin1.dll inclu doit être présent dans le chemin d'exécution DOS
(PATH) pour que l'executable programw.exe (où program est rngl,
sigmd ou indce) fonctionne sous windows.
Le programme Telem.java est aussi inclu, pour le recompiler avec lesdk de SUN il
suffit de taper dans une fenêtre DOS ou shell linux "javac Telem.java "et pour
l'exécuter "java Telem",
sinon, il est inclu en applet dans la
page
réglage de télémétrie.
Merci de nous signaler les bogues ou de nous indiquer les
programmes similaires, améliorés, traduits ou adaptés.

6) What
about oil
film measurement on tinplate. chrome oxide (tin free
steel), steel, aluminum, and other metals
?
Many ellipsometer are available for that purpose but very few are
adapted for simple measurements in industrial production
environment for metallic surfaces.
Among them, the Donart Model CA Ellipsometer (https://www.donartelectronics.com/ellipsometer-es1)
has interesting specifications for many specialist in ellipsometry
:
SPECIFICATIONS
REPEATABILITY
. . . . . . . . . . . . . . . . . . . . . . . . .
. . +/- 0.15 gm/bb (+/- .75 mg/m2)
ANGULAR RANGE
.
. . . . . . . . . . . . . . . . . . . . . . . .
20 degrees
MEASUREMENT RANGE
.
. . . . . . . . . . . . . . . . . . . In excess of
1.0 gm/bb (50 mg/m2)
SAMPLE
SIZE . . . . . . . . . . . . . . . .
. . . . . . . . . . . . 1 to 3 inch diameter
READOUT . .
. . . . . . . . . . . . . . . . . . . . . . . . . . . . .
Direct in oil coating
weight
with LED numerals
MEASUREMENT TIME
. . . . . . . . . . . . . . . . . . . . . .
Approximately 45
seconds
POWER REQUIREMENTS
. . . . . . . . . . . . . . . . . . . . 115 Volts,
60 Hz, 600 VA
(50
Hz, 220 Volt options)
VENT
SIZE . . . . . . . . . .
. . . . . . . . . . . . . . . . . . . . . 3
inch diameter
CABINET SIZE
. . . . . . . . . . . . . . . . . . . . . . . . . . . .
. 24" X
50" X 25"
APPROXIMATE
WEIGHT . . . . . . .
. . . . . . . . . . . . .
300 lbs.
(Found on http://www.donartelectronics.com/ellipsometer.htm
the january 28 2003)
The angular range of 20 degree means that only the Analyzer of this
PSCA type monochromatic null ellipsometer is compensating Delta.

These specifications do not give the angle of incidence and the
wavelength operating measurements.
In fact some of these aparatus are at 45° of incidence with
incandescent tungsten source filtered in yellow at around 590 nm.
Fixed polarizer means, in that case, that Psi should not vary very
much in all the practical range of measurements.
Considering practical case with transparent oil having 1.451
of refractive index and metal substrate with complex Index (2.0 -
i 2.0), simulation gives cyclic locus with a period of 232.8 nm of
oil thickness in the Psi-Delta Plane :
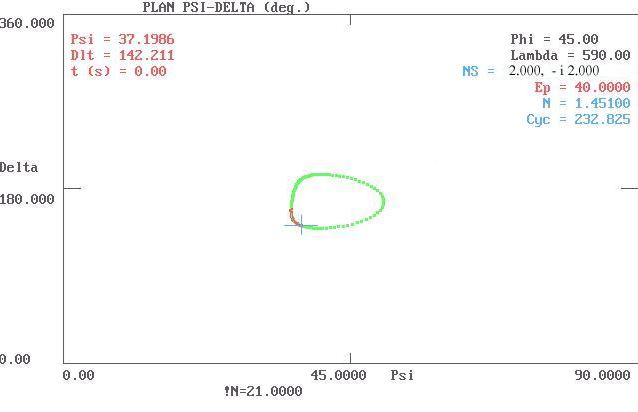
The analyzer has a rotation amplitude of 20°, that means that 40°
Delta variation can be detected.
From 0 to 40 nm oil film thicknesses the couples of values (Psi,
Delta) vary from (35.61°, 158.78°) to (37.1986°, 142.211°).
In other words, Psi varies of less of 2° when Delta has a
variation of around 16° for that range of 40 nm thickness
variation starting from 0.
Of course, beyond of these 40 nm of oil thickness Psi is
increasing significantly before Delta start to decrease and
it yields troubles in measurements of oil deposited
quantities in minimizing only Delta for that case (1.451 oil
refractive index and (2.0 -i 2.0) complex metallic refractive
index).
The repeatability around +/- .75 mg/m2 is about +/-1 nm in oil film thickness.
Other investigations should be necessary in order to characterize
any substrate rugosity, oxydation, polymer or oil multilayer
arrangement. Sensitivity and repeatability could be improved in
ajusting angle of incidence and operating wavelength of
measurement.

7) Pourriez
vous nous indiquer une présentation simplifiée de l'ellipsométrie
?
Suite à plusieurs demandes, nous avons préparé une présentation
de
l'ellipsométrie en 12 transparents :
Le fichier Powerpoint avec commentaires et son diaporama en un
seul fichier compressé : http://perso.wanadoo.fr/aime.vareille/pages/ellipsometrie/EllipsometrieSimplifiee.zip

La correction de cette page est assurée par aime.vareille@wanadoo.fr
Page
suivante Page
précédente Table
des
matières